 |
| (사진출처=게티이미지) |
부품업체들이 고밀도 회로기판 등 고부가 반도체 패키지기판 사업에 열을 올리고 있다. 특히 FC-BGA로 대표되는 차세대 반도체 기판의 경우, 주요 전자 부품업체들의 새로운 성장 동력으로 떠오르는 중이다. 데이터 센터와 IT 등의 수요 확대로 차세대 기판의 몸값이 상승하면서 자체 시장 성장과 함께 향후 반도체 산업의 발전에도 영향을 미칠 것이라는 분석이다.
반도체 패키지 기판은 기본적으로 일반 인쇄회로기판(PCB)처럼 부품 간 전기 신호 등을 연결하는 기능을 수행한다. 특히 반도체와 메인기판 간의 단자들의 재배선을 통해 전기적 신호를 전달한다. 반도체 패키지 기판은 실리콘으로 제작되는 반도체 특성상 온도나 습도 등 외부 스트레스 등에서 칩을 보호하는 기능도 갖추고 있어야 한다.
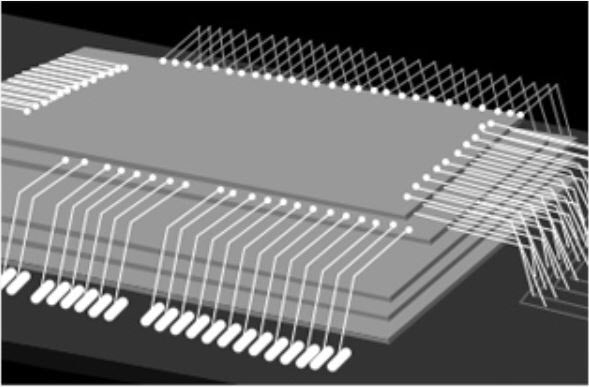 |
| WB-CSP 제품 이미지. (사진제공=삼성전기) |
특히 고밀도 회로기판은 모바일과 PC 등에 탑재되는 반도체에 주로 사용되는 패키지 기판을 말한다. 최근 전자부품 업계가 주목하고 있는 FC-BGA 기판 등이 포함된다.
고밀도 회로기판은 기판을 반도체에 연결하는 방식에 따라 크게 두 가지로 분류된다. 첫째는 반도체의 네 가장자리 면을 ‘선’으로 연결하는 와이어 본딩(Wire Bonding) 방식이다.
대표적으로 WB-CSP(Wire Bonding Chip Scale Package) 등이 있다. 와이어 본딩 방식 중 반도체 칩 크기가 기판 면적의 80% 넘는 제품을 뜻한다. 멀티 패키징이 가능해 모바일용 메모리 칩 등에 주로 사용되는 유형이다.
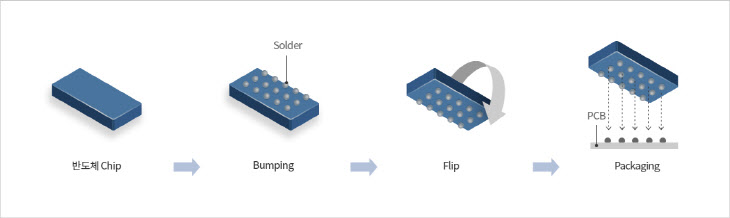 |
| FC-CSP 기판 개념도. (사진제공=삼성전기) |
선 대신 작은 볼을 활용해 기판과 반도체를 연결하는 플립칩(Flip Chip) 방식의 기판도 있다. 와이어 본드 방식의 경우, 전기 신호가 이동하는 접촉 단자의 수가 한정적이라는 단점을 보완한 방식이다. 플립칩은 선 대신 작은 볼을 이용해 반도체와 패키지 기판의 접촉면에 더 많은 접촉단자를 형성할 수 있다. FC-CSP(Flip Chip Chip Scale Package) 등이 대표적이다. 해당 제품은 반도체와 범프를 통해 뒤집어진 채로 기판과 연결되는 방식이다. 신호 이동 거리가 와이어 본드 방식보다 단축돼 고밀도 반도체 활용이 가능하다는 장점이 있다. 주로 모바일 IT 기기의 어플리케이션 반도체에 사용된다. FC-CSP는 구체적으로 EPS/EDS 기판과 ETS 기판 등으로 분류된다. EPS/EDS 기판은 반도체 수동소자, IC 등을 기판 내부에 내장해 패키지 크기와 두께를 줄인 방식이다. ETS는 회로 패턴이 절연재 안에 있는 형태다. 미세회로 구현이 가능하고, 회로 폭도 정밀하게 제어할 수 있다.
![[참고사진]삼성전기 반도체 패키지기판(CPU용) 제품사진 (2)](https://www.viva100.com/mnt/images/file/2022y/06m/20d/2022061901000979000040851.jpg) |
| 반도체 패키지기판(CPU용) 제품. (사진제공=삼성전기) |
최근 전자업계가 주목하고 있는 FC-BGA(Flip Chip Ball Grid Array) 역시 플립칩 방식의 기판이다. FC-BGA는 특히 고집적 반도체 칩을 메인보드와 연결하기 위해 고안된 고집적 패키지 기판이다. 이를 위해 반도체 칩과 패키지 기판을 플립칩 범프로 연결하고, 전기와 열적 특성을 향상한 기판이다. 고성능, 고집적 기판인 만큼 고밀도 회로 연결을 필요로 하는 CPU(중앙처리장치), GPU(그래픽 처리장치)에도 주로 사용된다. 적용 분야도 PC제품과 각 서버, TV와 셋톱 박스, 게임 콘솔 등 다양한 분야에서 응용 및 사용되고 있다.
업계와 관련 기업 추정치에 따르면, FC-BGA 시장의 경우, 서버·네트워크 등 고속 신호처리 수요가 늘면서 중장기적으로 연간 14% 이상 성장할 것으로 추산되고 있다. 오는 2026년까지는 수요가 지속적으로 유지될 것이라는 관측이다.
다만 FC-BGA의 경우, 구현과 양산을 위한 기술적인 난이도가 다른 고밀도 회로기판보다 높다는 단점이 있다. CPU 기판 회로의 고집적화 등으로 많은 기판 층수와 미세회로의 구현 및 층간 미세 정합을 요구하며, 동시에 세트 슬림화를 위한 박형 기판 제조 기술도 동시에 요구하기 때문이다.
이런 기술적 난이도에도 불구하고 견조한 수요와 수익성이 예상되는 만큼, 국내 주요 전자 부품기업들은 잇달아 FC-BGA를 위시한 고밀도 회로기판의 양산과 개발에 나서고 있다.
삼성전기는 지난해 말 베트남 생산법인에 위치한 FC-BGA의 생산 설비와 인프라 구축에 총 8억5000만달러를 투자한다고 밝힌 바 있다.
이어 4월에는 부산에도 3000억원을 추가로 투자한다고 공시했다. 이를 통해 회사는 베트남은 FC-BGA의 생산 거점으로, 수원·부산사업장은 기술 개발과 하이엔드 제품 생산 기지로 각기 전문화할 계획이다. 삼성전기는 애플의 차세대 CPU인 M1에도 FC-BGA를 납품하는 등 고객사를 확대하고 있다.
LG이노텍 역시 FC-BGA를 중심으로 반도체 패키지 기판에 대한 투자 의사를 드러내고 있다. 회사는 지난 2월 4130억원을 관련 반도체 기판 생산 시설에 투자하는 등 설비 투자를 지속적으로 늘릴 예정이다.
우주성 기자 wjsburn@viva100.com







![[비바100] 전자업계, 지구 생각하는 '착한 전자기기' 선보인다!](https://www.viva100.com/mnt/images/file/2024y/03m/25d/2024032401001708200076141.jpg)
![[비바100] 인터배터리로 본 업계 관심사 ‘셀투팩’…“싼데 멀리 나가네”](https://www.viva100.com/mnt/images/file/2024y/03m/11d/2024031001000573200025751.jpg)
![[비바100] 전기차 판매가격…'배터리 기술'에 달렸다](https://www.viva100.com/mnt/images/file/2024y/02m/26d/20240225010007059_1.jpg)

























